방사선이 반도체에 미치는 영향
방사선이 반도체에 미치는 영향은 다음의 세 가지로 분류할 수 있습니다.
1. SEE (Single Event Effects)
SEE (Single Event Effect)는 방사선(양성자, 중성자, 중이온, 감마선 등) 반도체 내부를 통과하는 과정에서 매질을 이온화시켜 회로의 동작에 오류를 유발하여 일어납니다. 이온화 과정에서 생성된 전자와 전공 쌍이 반도체의 민감 영역에 도달하고 그 양이 동작의 상태를 바꾸기에 충분하면 오류에 이르게 됩니다. SEE는 대부분 비파괴적이고 일시적인 오류로서 값이나 전원을 재설정하면 정상 동작을 재개할 수 있습니다.
일반적으로 중이온을 통해 평가를 진행합니다.
SEE 유형
- SEU (Single Event Upset): 데이터 비트 플립
- SET (Single Event Transient): 순간적인 전압 펄스
- SEL (Single Event Latch-up): CMOS 구조 내 PNPN 경로의 단락
- SEB (Single Event Burnout) / SEGR (Single Event Gate Rupture): 고전력 소자 파괴
- SEFI (Single Event Functional Interrupt): 시스템 수준의 작동 중단
2. TID (Total Ionizing Dose)
방사선에 의해서 생성된 전하는 반도체 내부에 누적되어 점진적으로 반도체의 특성에 변화를 가져올 수 있습니다. 이를 표현하는 방법이 TID(총 이온화 선량)입니다. CMOS소자의 경우는 절연층에 이온화 선량의 의해서 생성된 전하가 트래핑(Charge Trapping)되거나 결정 구조에 결함을 만들 수 있습니다.
일반적으로 감마선을 통해 TID평가를 진행합니다.
주요 영향
- MOSFET 임계전압(Vth) 변화
- 문턱전압 역전 및 드레인 누설 전류 증가
- 동작 특성 변화
3. DD (Displacement Damage)
Displacement Damage(DD)는 반도체 벌크 내에서 발생하며, 표면 또는 계면에 국한된 Total Ionizing Dose(TID)와는 달리 소자 벌크 전영역에 발생하는 손상입니다. 이로 인해 반도체의 전기적·광학적·열적 특성이 변화하여 소자의 성능 저하나 기능 상실을 유발할 수 있습니다.
일반적으로 중성자를 이용하여 평가를 진행합니다.
- 주요 영향
- 소자 캐리어 수명 및 이동도 감소
- PN 다이오드 역포화 전류 증가
- 전체적인 성능 저하
주요 영향
- 소자 캐리어 수명 및 이동도 감소
- PN 다이오드 역포화 전류 증가
- 전체적인 성능 저하
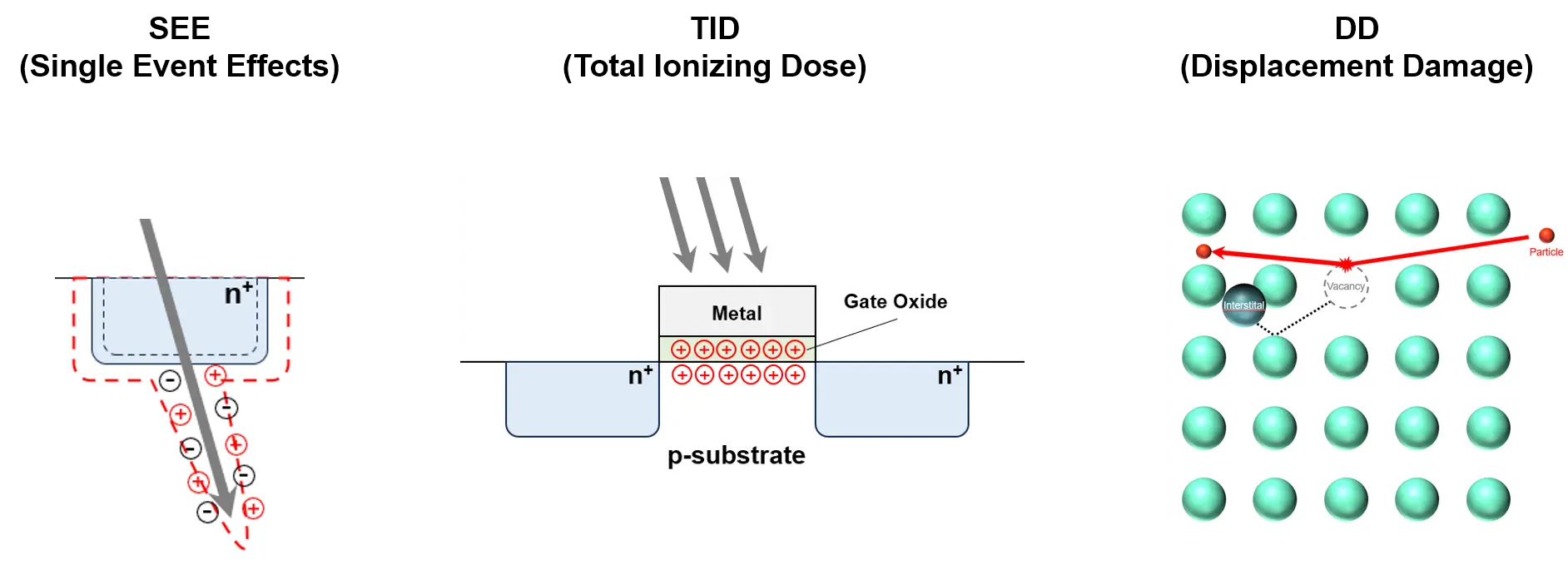
방사선이 반도체에 미치는 영향
방사선의 종류
여러 방사선 중 일반적으로 반도체에 영향을 주는 방사선은 다음과 같습니다.
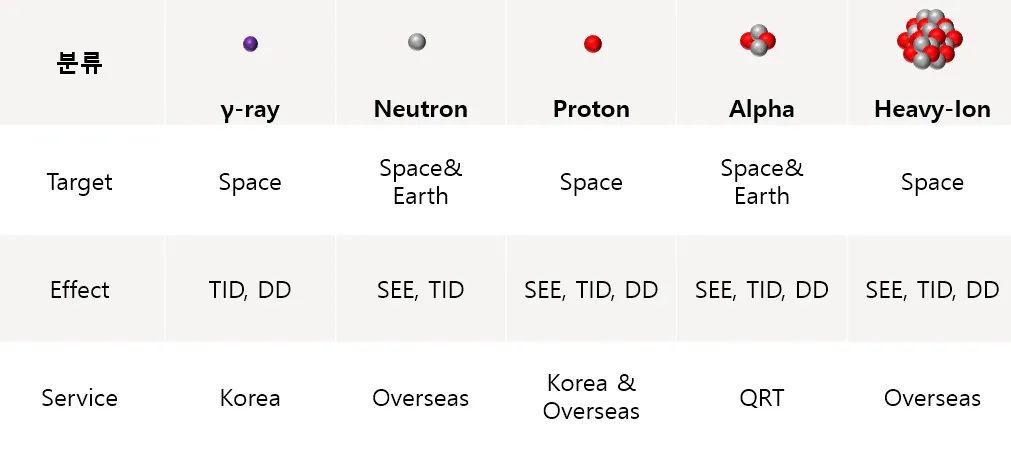
감마선
지상에서의 감마선으로 인한 영향은 무시 가능한 수준입니다. 하지만 우주에서는 TID(Total Ionizing Dose)로 인한 영향은 큽니다. 또한 조사된 감마선에 의해 생성된 Secondary electron에 DD(Displacement damage)를 입기도 합니다.
중성자
중성자는 항공기 등 지상 환경과 우주 모두 관련이 있습니다. 지상에서는 우주에서 날아온 중성자가 SEE를 유발하며 우주 환경에서는 DD의 주된 원인입니다.
양성자
양성자는 태양이나 밴 앨런대에서 많은 입자로 SEE, TID, DD를 전부 유발합니다. 지상에서는 무시 가능한 수준이지만 우주 환경에서는 필수 평가 항목입니다.
알파입자
반도체 패키징 등에 존재하는 동위원소의 붕괴 특히 붕소(B^10)에서 배출된 알파 입자는 SEE, TID, DD를 전부 유발할 수 있습니다. 이런 알파입자로 인해서 발행하는 SEE는 Am-241 같이 비교적 쉽게 구할 수 있는 알파 소스를 활용하여, 실험실 내에서 간편하게 평가가 진행 가능하다는 장점이 있습니다.
중이온
우주 방사선 중 고 LET 입자로 SEE, TID, DD를 전부 유발할 수 있고 SEE 평가에 주로 사용됩니다. 표준 시험 절차로는 JEDEC JESD57 및 ESCC 25100이 대표적입니다.
위 방사선은 각각 다른 방식으로 반도체에 영향을 주며, 그 메커니즘은 각 항목을 클릭하시면 확인할 수 있습니다.


